Полупроводниковые приборы из карбида кремния при сверхвысоких напряжениях и их применение.
Всем привет. Добро пожаловать в новый пост сегодня. Сегодня я познакомлю вас с полупроводниковыми приборами из карбида кремния.
Темы, затронутые в этой статье: |
Ⅰ. Понимание различных экспериментальных моделей |
Ⅱ. Тестирование различных уровней параметрической чувствительности в разных условиях |
Ⅲ. Заключение |
Несмотря на достижения в области полупроводниковых технологий, традиционные силовые электронные системы, состоящие из кремния, все еще используются сегодня. Биполярные транзисторы с кремниевой изоляцией всегда использовались при преобразовании источников напряжения для создания гибких систем передачи переменного тока (FACTS) и передачи постоянного тока высокого напряжения (HVDC). Для дальнейшего повышения эффективности с точки зрения производительности и с учетом общей стоимости устройства карбид кремния (SiC) является новой тенденцией в области электроники.
SiC имеет превосходные физические и электрические свойства по сравнению с Si и поэтому используется в широком спектре силовой электроники. Полупроводниковые устройства, состоящие из SiC, имеют сильную напряженность поля эклектического пробоя, благодаря чему можно увидеть уменьшенную толщину дрейфовой области с более высокими возможностями запирающего напряжения.
В ходе эксперимента были проверены характеристики высоковольтных SiC-устройств, таких как MOSFET, IGBT, SB-диоды и PiN-диоды, в условиях высокого напряжения и запирающего напряжения 20 кВ. Также были проведены испытания для дальнейшего расширения напряжения блокировки, например, SiC MOSFET до 20 кВ, а также SiC GTO.
Ⅰ. Понимание различных экспериментальных моделей
Пока проводился этот эксперимент, было изучено и проанализировано четыре модели проведения сверхвысоких напряжений.
А. Общий подход к моделированию: В общем подходе к моделированию было сделано исходное предположение, в котором учитывались различные электрические параметры, такие как управляемость затвора, сопротивление затвора и паразитная индуктивность. В этом подходе потери проводимости и потери переключения используются при расчете общих потерь мощности. При этом можно определить максимально допустимую плотность тока и частоту переключения для заданного максимального предела рассеиваемой мощности, например: PD,MAX=300 Вт/см2.

Приведенное выше уравнение показывает полученную общую мощность и рассчитанную максимальную частоту соответственно.

Рис. 1. Запирающее напряжение в зависимости от концентрации легирования области дрейфа и расчетной концентрации легирования области дрейфа с шириной области дрейфа.
На рис. 1 показано теоретическое напряжение блокировки в зависимости от концентрации легирования дрейфового слоя, а на рис. 2 показаны конкретные концентрации легирования и ширина области дрейфа для устройств, используемых в этой модели.
B. Модель SiC MOSFET: для определения характеристик открытого состояния SiC MOSFET в устройстве наследуются такие параметры, как сопротивление МОП-канала, сопротивление дрейфовой области и сопротивление подложки. Для устройств MOSFET с запирающим напряжением выше 1,2 кВ вклад сопротивления, возникающий из области дрейфа, выше, чем другие вкладные сопротивления.

Рис. 2. Температурная зависимость пиковой крутизны и порогового напряжения SiC MOSFET, результаты моделирования плотности потерь мощности проводимости SiC MOSFET и плотности потерь мощности переключения.
На рисунке выше показаны температурно-зависимые и пиковые параметры крутизны и напряжения для SiC MOSFET 10 кВ. Напряжение переключения поддерживается на уровне 60 % напряжения блокировки (VDS=0,6 ВБ). Кроме того, также были представлены результаты моделирования плотности потерь мощности проводимости и плотности потерь мощности переключения. Расчетная плотность потерь мощности проводимости составляет от 30 Вт/см2 до 60 Вт/см2 в диапазоне от 10 до 20 кВ при J=15 А/см2 и T=300 К.
C. Модель SiC IGBT: Потери проводимости биполярных устройств SiC состоят из двух частей: напряжения колена (VKNEE), которое находится рядом с элементом внутреннего сопротивления, присутствующего в устройстве, аналогичного RON.

Рис. 3. Напряжение колена SiC IGBT, смоделированная плотность потерь мощности проводимости SiC IGBT и плотность потерь мощности переключения.
SiC обладает многими современными высоковольтными характеристиками, которые можно использовать при извлечении параметров VKNEE и RON, как показано на рис. 3. Прямое падение напряжения для SiC IGBT можно представить как:

Из приведенного выше уравнения LCH — это длина MOS-канала, а μni — подвижность канала, p — шаг ячейки, VG — напряжение затвора, а COX — оксидная емкость, которую можно определить по формуле COX=εOX/tOX. Обратное восстановление диода не рассматривалось, вместо этого потери энергии при включении предполагались равными потерям энергии при выключении. Характеристики переключения этого устройства зависят от обратного восстановления обратного диода при включении и удалении носителей заряда в области дрейфовой структуры IGBT.
D. Модель тиристора SiC GTO. Подобно SiC IGBT, модель тиристора SiC GTO также допускает потери проводимости в том же подходе к моделированию. Для сравнения результатов SiC IGBT и SiC GTO используется та же модель напряжения колена, что и для «смешанной модели».

Из приведенного выше уравнения EG — это энергия запрещенной зоны SiC, а A — площадь устройства. Как и в случае с SiC IGBT, потери в SiC GTO состоят из потерь во время нарастания напряжения и остаточного тока. Толщина области (WP) установлена на уровне 50 % толщины области (WN).
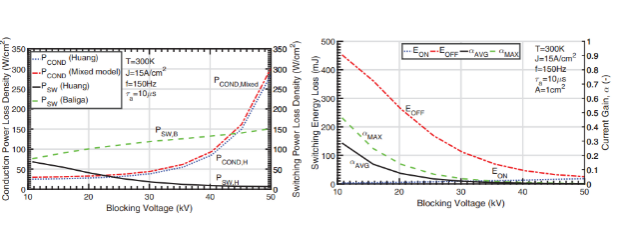
Рис. 4. Результаты моделирования плотности потерь мощности проводимости тиристора SiC GTO и плотности потерь мощности переключения, потерь энергии при включении и выключении GTO с максимальным коэффициентом усиления по току.
В приведенном выше уравнении показаны результаты моделирования испытаний различных параметров тиристора SiC GTO в различных условиях. Было видно, что потери мощности переключения возрастают по мере увеличения напряжения блокировки. С другой стороны, потери при включении, которые считались основной частью общих потерь, показали явное снижение тенденции.
Ⅱ. Тестирование различных уровней параметрической чувствительности в разных условиях
Устройства, изготовленные из SiC MOSFET, SiC IGBT и SiC GTO-тиристоров, тестировались и экспериментировались в тех же условиях, где J=15 А/см2, T=300 К, Ta=10 мкс и f=150 Гц. Эксперимент проводился с целью проверки возможностей сверхвысоковольтных устройств на основе SiC, которые сегодня не очень популярны в полупроводниковой промышленности. В связи с этим могут существовать определенные неопределенности в параметрах моделирования, поэтому был проведен тест параметрической чувствительности.

Рис. 5. Максимальная плотность тока и максимальная частота коммутации.
Как показано на рисунке 5, максимально допустимая плотность тока и максимальная частота переключения определяются при заданных условиях T=300 К, IJa=10 мкс и f=150 Гц. Из приведенного выше моделирования стало ясно, что SiC-МОП-транзисторы могут использоваться на частотах переключения выше, чем SiC-IGBT и SiC-тиристоры GTO.
Ⅲ. Заключение
В этом эксперименте были предложены различные подходы к моделированию, которые исследуют использование сверхвысоковольтных SiC MOSFET, SiC IGBT и SiC GTO-тиристоров. Было проведено несколько симуляций, которые смогли доказать, что SiC MOSFET обладают наибольшей способностью выдерживать ток до 15 кВ. SiC IGBT могут использоваться для блокировки напряжений в диапазоне от 15 до 35 кВ, а тиристор SiC GTO больше подходит для напряжений более 35 кВ.


















