Введение в пакет BGA
Корпус BGA (шариковая решетка) представляет собой технологию поверхностного монтажа высокой плотности. В нижней части корпуса все контакты имеют сферическую форму и расположены в виде сетки, отсюда и название BGA.
Каталог |
Ⅰ Что такое пакет BGA? |
Ⅱ Особенности пакета BGA |
Ⅲ Классификация корпуса BGA |
Ⅳ Процесс процесса |
Ⅰ Что такое пакет BGA?
LSI, VLSI и ULSI возникли одна за другой в 1990-х годах благодаря достижениям в области технологий интеграции, усовершенствованию оборудования и использованию глубокой субмикронной технологии. Интеграция однокристальных кремниевых кристаллов продолжает расти, требования к корпусам интегральных схем становятся более строгими, количество контактов ввода-вывода резко увеличивается, а энергопотребление увеличивается. Для удовлетворения потребностей разработки на основе исходных разновидностей упаковки была добавлена новая разновидность — BGA Package (Ball Grid Array Package).
Клеммы ввода-вывода корпуса BGA расположены под корпусом в виде массива круглых или столбчатых паяных соединений. Память, реализованная по технологии BGA, позволяет увеличить объем памяти в два-три раза без изменения ее размера. По сравнению с TSOP, BGA имеет меньший объем, лучшие характеристики рассеивания тепла и электрические характеристики. Технология упаковки BGA значительно улучшила емкость хранилища на квадратный дюйм. Продукты памяти, использующие технологию упаковки BGA, имеют лишь треть объема корпуса TSOP при той же емкости. Кроме того, по сравнению с традиционным методом упаковки TSOP, корпус BGA является более быстрым и эффективным способом рассеивания тепла.
Ⅱ Особенности пакета BGA
Как только появился BGA, он стал лучшим выбором для высокоплотных, высокопроизводительных, многофункциональных корпусов с большим количеством контактов ввода-вывода для микросхем VLSI, таких как процессоры и мосты север-юг.
Его характеристики:
1. Хотя количество контактов ввода-вывода увеличилось, расстояние между контактами намного больше, чем у QFP, что повышает производительность сборки;
2. Несмотря на увеличение энергопотребления, BGA можно сваривать методом контролируемого разрушения стружки, называемым сваркой C4, что может улучшить его характеристики электрического нагрева;
3. По сравнению с QFP толщина уменьшена более чем на 1/2, а вес уменьшен более чем на 3/4;
4. Паразитные параметры уменьшены, задержка передачи сигнала мала, а частота использования значительно улучшена;
5. Для сборки можно использовать копланарную сварку, что обеспечивает высокую надежность;
6. Корпус BGA по-прежнему такой же, как QFP и PGA, и занимает слишком большую площадь подложки;
Корпорация Intel имеет высокий уровень интеграции (более 3 миллионов транзисторов в одном кристалле) и процессорные чипы с высоким энергопотреблением, такие как Pentium, Pentium Pro, Pentium Ⅱ, с использованием корпуса с керамической решеткой выводов CPGA и корпуса матрицы с керамической шариковой сеткой CBGA. и установите на корпус миниатюрный вытяжной вентилятор для рассеивания тепла, чтобы обеспечить стабильную и надежную работу схемы.
Ⅲ Классификация корпуса BGA
Существует множество типов корпусов BGA, которые можно разделить на периферийные, шахматные и
Пакет PBGA 1 и полный тип массива в зависимости от расположения шариков припоя.
В зависимости от различных подложек он в основном делится на PBGA (пластик BGA), CBGA (керамический BGA), FCBGA (Filpchip BGA), TBGA (ленточный BGA).
PBGA-пакет
PBGA — это наиболее часто используемая форма корпуса BGA, изготовленная из пластиковых материалов и пластиковых процессов. Тип используемой подложки — материал подложки печатной платы (смола BT/стеклянный ламинат). После того, как голый чип соединен с верхней частью подложки и выводной рамкой с помощью склеивания и технологии WB, общий пластик достигается путем литья под давлением (смесь эпоксидной пленки и пластика). Все процессоры серии Intel, Pentium II, III, IV имеют такую форму упаковки.

PBGA-пакет 1
Материал шарика припоя — легкоплавкий эвтектический припой 63Sn37Pb диаметром около 1 мм и шагом шага 1,27-2,54 мм. Соединение шарика припоя с нижней частью корпуса не требует дополнительного припоя. При сборке шарики припоя плавятся и соединяются с пластиной припоя на поверхности печатной платы, образуя бочкообразную форму.

PBGA-пакет 2
Характеристики пакета PBGA в основном проявляются в следующих четырех аспектах:
1. Низкая себестоимость и высокая себестоимость.
2. Шарики припоя участвуют в формировании паяных соединений оплавлением.
3. Хорошее термическое соответствие подложке из эпоксидной смолы, высокое качество и хорошие характеристики при сборке на печатную плату.
4. Чувствительность к влаге, эффект PoPCorn серьезен, а высота упаковки QFP также является технической проблемой.
пакет CBGA
CBGA формируется путем установки голого чипа на верхнюю поверхность керамической многослойной подложки. Металлическая крышка припаяна к подложке герметизирующим припоем для защиты чипа, выводов и площадок. Подключенный пакет герметичен. Все процессоры Pentium I, II и Pentium Pro использовали этот пакет.

Пакет CBGA 1
CBGA использует многослойную керамическую подложку. Материал шарика припоя представляет собой эвтектический припой 90Pb10Sn с высокой температурой плавления. Для соединения шарика припоя с корпусом упаковки используется низкотемпературный эвтектический припой 63Sn37Pb, а также крышка + стеклянное воздушное уплотнение, которое относится к категории герметичной упаковки.
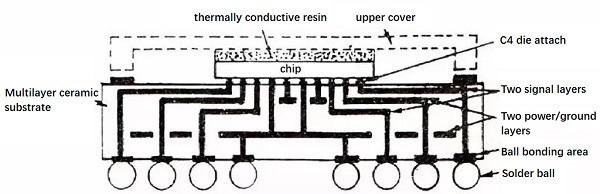
Пакет CBGA 2
Характеристики пакета CBGA в основном проявляются в следующих шести аспектах:
1. Нечувствительность к влаге, хорошая надежность, отличные электрические и тепловые характеристики.
2. Хорошее соответствие КТР керамической подложки.
3. Улучшена ремонтопригодность соединительных микросхем и компонентов.
4. Голый чип использует технологию FCB, а плотность межсоединений выше.
5. Более высокая стоимость упаковки.
6. Плохое соответствие КТР эпоксидной смолы и других материалов.
пакет ФКБГА
FCBGA в настоящее время является наиболее важным форматом упаковки для чипов ускорения графики. Эта упаковочная технология возникла в 1960-х годах. В то время IBM разработала так называемую технологию C4 (Controlled Collapse Chip Connection) для сборки больших компьютеров. Затем она получила дальнейшее развитие до такой степени, что поверхностное натяжение расплавленных выступов можно было использовать для поддержки веса чипа и контроля высоты выступов, и это стало направлением развития технологии перевернутых чипов.
В этом корпусе для подключения к процессору вместо контактов используются маленькие шарики. Всего требуется 479 шариков диаметром 0,78 мм, что позволяет обеспечить кратчайшее расстояние внешнего соединения. FCBGA соединен с подложкой посредством технологии FCB. Отличие от PBGA в том, что голая микросхема обращена вниз.
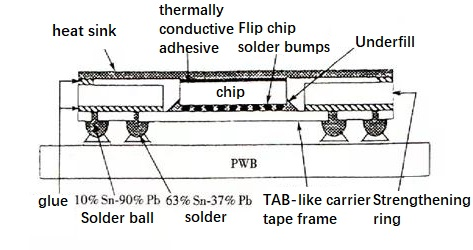
пакет ФКБГА
Характеристики упаковки FCBGA в основном проявляются в следующих трех аспектах:
1. Отличные электрические характеристики, при этом снижаются потери и индуктивность между соединениями компонентов, уменьшаются проблемы с электромагнитными помехами и выдерживает более высокие частоты.
2. Увеличьте плотность ввода-вывода, повысьте эффективность использования и эффективно уменьшите площадь подложки на 30–60%.
3. Хорошее рассеивание тепла, что может улучшить стабильность чипа во время высокоскоростной работы.
пакет ТБГА
TBGA, также известный как автоматическое склеивание несущей ленты массива, представляет собой относительно новую форму корпуса BGA. Тип используемой подложки — многослойная проводящая подложка PI, материал шарика припоя — припой с высокой температурой плавления, а для пайки используется припой с низкой температурой плавления.

пакет ТБГА
Характеристики упаковки TBGA в основном проявляются в следующих пяти аспектах:
1. Хорошее термическое соответствие подложке печатной платы из эпоксидной смолы.
2. Самая тонкая форма корпуса BGA способствует уменьшению толщины чипа.
3. По сравнению с CBGA стоимость ниже.
4. Чувствителен к жаре и влажности.
5. Чип легкий и маленький, а отклонение самокалибровки велико по сравнению с другими типами BGA.
Ⅳ Процесс процесса
Подложка или промежуточный слой — очень важная часть корпуса BGA. Кроме того, для соединения проводов его также можно использовать для контроля импеданса и для интеграции индуктивности/сопротивления/емкости. Поэтому материал подложки должен иметь высокую температуру стеклования rS (примерно 175~230°C), высокую стабильность размеров и низкое влагопоглощение, а также хорошие электрические свойства и высокую надежность. Металлическая пленка, изоляционный слой и подложка также должны обладать более высокими адгезионными свойствами.
1. Процесс упаковки PBGA
① Подготовка подложки PBGA
Заламинируйте очень тонкую (толщиной 12–18 мкм) медную фольгу с обеих сторон платы из смолы/стекла BT, а затем выполните сверление и металлизацию сквозных отверстий. Используйте традиционную технологию PCB plus 3232 для создания рисунков на обеих сторонах подложки, таких как проводящие полосы, электроды и набор площадок для установки шариков припоя. Затем добавьте паяльную маску и сделайте шаблон, обнажая электрод и область пайки. Чтобы повысить эффективность производства, субстрат обычно содержит несколько субстратов PBG.
② Процесс упаковки
Утончение пластин → резка пластин → склеивание чипов → плазменная очистка → сварка проводов → плазменная очистка → формованная упаковка → сборка шариков припоя → пайка оплавлением → маркировка поверхности → разделение → окончательный контроль → упаковка испытательного бункера
Чип приклеен к подложке с помощью эпоксидного клея с серебряным наполнителем. Затем для соединения чипа с подложкой используется соединение золотой проволокой. Затем для защиты чипа, линии пайки и площадки используется формованный пластиковый пакет или заливка жидким клеем. Специально разработанный захват используется для размещения шариков припоя 62/36/2Sn/Pb/Ag или 63/37/Sn/Pb с температурой плавления 183°C и диаметром 30 мил (0,75 мм) на колодки и оплавляем их в обычной печи оплавления с максимальной температурой обработки не более 230°С. Затем подложка очищается центрифугой с помощью неорганического очистителя CFC для удаления частиц припоя и волокон, оставшихся на упаковке. Далее следует маркировка, разделение, окончательная проверка, испытания и упаковка для хранения. Выше описан процесс свинцового склеивания упаковки PBGA.
2. Процесс упаковки FC-CBGA
① Керамическая подложка
Подложка FC-CBGA представляет собой многослойную керамическую подложку, и ее изготовление достаточно сложно. Поскольку плотность проводки подложки высокая, шаг узкий, имеется много сквозных отверстий, а компланарность подложки относительно высока.
Его основной процесс: сначала совместный обжиг многослойного керамического листа с многослойной керамической металлизированной подложкой при высокой температуре, затем выполнение многослойной металлической проводки на подложке, а затем гальваника. При сборке CBGA несоответствие КТР между подложкой, микросхемой и печатной платой является основным фактором, вызывающим выход из строя продуктов CBGA. Чтобы улучшить эту ситуацию, в дополнение к структуре CCGA также можно использовать другую керамическую подложку - керамическую подложку HITCE.
②Процесс упаковки
Подготовка выступов пластины -> нарезка пластины кубиками -> переворот чипа и пайка оплавлением -> заполнение термопастой, нанесение герметизирующего припоя -> покрытие -> сборка шарика припоя -> пайка оплавлением -> маркировка -> разделение -> окончательная проверка -> испытание -> Упаковка
3. Процесс упаковки TBGA
① Лента ТБГА
Несущая лента ТБГА обычно изготавливается из полиимидного материала.
В процессе изготовления обе стороны несущей ленты сначала покрываются медью, затем никелем и золотом. Далее производят сквозную штамповку, сквозную металлизацию и графику. В этом TBGA со свинцовым соединением инкапсулированный радиатор является прочным дополнением к корпусу и подложке полости ядра корпуса, поэтому перед инкапсуляцией несущая лента прикрепляется к радиатору с помощью чувствительного к давлению связующего вещества.
②Процесс упаковки
Утончение пластин → резка пластин → склеивание чипов → очистка → соединение проводов → плазменная очистка → заливка жидким герметиком → сборка шариков припоя → пайка оплавлением → маркировка поверхности → разделение → окончательный контроль → тестирование → упаковка

Frequently Asked Questions


















